【導讀】功率MOSFET工作在線(xiàn)性區用來(lái)限制電流,VGS電壓低,通常在負溫度系數區,局部單元過(guò)熱導致其流過(guò)更大的電流,結果溫度更高,從而形成局部熱點(diǎn)導致器件損壞,這樣就形成一個(gè)熱電不穩定性區域ETI (Electro Thermal Instability),發(fā)生于VGS低于溫度系數為0(ZTC)的負溫度系數區。
1、線(xiàn)性區工作負溫度系數特性
功率MOSFET的轉移特性如圖1所示,VGS與電流ID曲線(xiàn)有一個(gè)溫度系數為0的電壓值5.5V,通常這個(gè)點(diǎn)就稱(chēng)為零溫度系數點(diǎn)ZTC(Zero Temperature Coefficient)。VGS高于5.5V時(shí),溫度越高電流越小,功率MOSFET的RDS是正溫度系數;VGS低于5.5V時(shí),溫度越高電流越大,功率MOSFET的的RDS是負溫度系數。
功率MOSFET內部通常是由許多晶胞單元并聯(lián)而成,如圖2所示。通常假定芯片內部處于理想的熱平衡狀態(tài),整個(gè)硅片的結溫完全一致。然而在實(shí)際條件下,硅片邊沿熱阻低,如圖3所示;由于硅片焊接的不均勻,各局部區的熱阻也不一致;此外,各局部區的閾值電壓VTH也不完全相同,它們通過(guò)的漏極電流,也就是(VGS-VTH)和跨導乘積,也不完全相同。上述因素導致局部區溫度也不一樣。
功率MOSFET工作在線(xiàn)性區用來(lái)限制電流,VGS電壓低,通常在負溫度系數區,局部單元過(guò)熱導致其流過(guò)更大的電流,結果溫度更高,從而形成局部熱點(diǎn)導致器件損壞,這樣就形成一個(gè)熱電不穩定性區域ETI (Electro Thermal Instability),發(fā)生于VGS低于溫度系數為0(ZTC)的負溫度系數區。
開(kāi)關(guān)電源中功率MOSFET工作于開(kāi)關(guān)狀態(tài),在截止區和完全導通區之間高頻切換,由于在切換過(guò)程中要經(jīng)過(guò)線(xiàn)性區,因此產(chǎn)生開(kāi)關(guān)損耗。完全導通時(shí),RDS處于正溫度系數區,局部單元的溫度增加,電流減小溫度降低,具有自動(dòng)的平衡電流的分配能力。但是在跨越線(xiàn)性區時(shí),會(huì )產(chǎn)生動(dòng)態(tài)的不平衡。
對于熱插撥、負載開(kāi)關(guān)、分立LDO的調整管等這一類(lèi)的應用,MOSFET較長(cháng)時(shí)間或一直在線(xiàn)性區工作,因此工作狀態(tài)和快速開(kāi)關(guān)狀態(tài)不同。功率MOSFET工作在線(xiàn)性狀態(tài),器件的壓降和電流都較大,功耗大,因此產(chǎn)生高的熱電應力,更容易導致熱不平衡的發(fā)生,從而形成局部熱點(diǎn)或局部電流集中,導致器件損壞;而且,也容易導致寄生的三極管導通,產(chǎn)生二次擊穿,從而損壞器件。
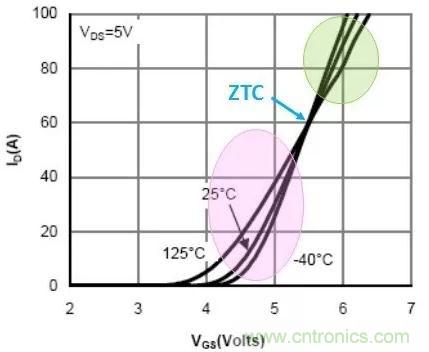
圖1:AOT462的轉移特性
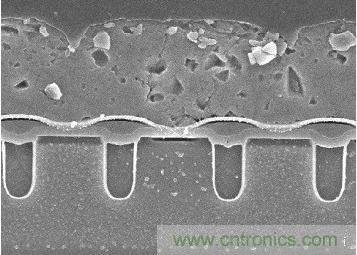
圖2:功率MOSFET內部晶胞單元

圖3:芯片內部散熱差異
正溫度系數區主要處決于載流子的產(chǎn)生,負溫度系數區主要處決于載流子的移動(dòng),因此表現出來(lái)的溫度特性不同。
器件的失效處取決于脈沖時(shí)間、散熱條件和功率MOSFET單元平衡性能。通常,ZTC對應的電流越大,對應的VGS越大,就越容易發(fā)生熱不穩定性問(wèn)題。而且ZTC直接和跨導相關(guān),跨導增加,ZTC點(diǎn)向更高的VGS點(diǎn)移動(dòng)。
相對傳統的平面工藝,新一代的工藝的MOSFET單元密度大,具有更大的跨導,因此更容易發(fā)生熱不穩定性問(wèn)題。另外,高壓的MOSFET比低壓MOSFET,在ZTC點(diǎn)具有更低的電流和VGS,這是因為高壓MOSFET的epi層厚,單元的Pitch較低,而且摻雜也低,所以RDS隨溫度變化決定著(zhù)在整個(gè)溫度范圍內跨導的變化,因此比低壓MOSFET發(fā)生熱不穩定性問(wèn)題的可能性降低。
2、線(xiàn)性區工作的電勢、空穴和電流線(xiàn)分布
MOSFET的漏極導通特性前面論述過(guò),其工作特性有三個(gè)工作區:截止區、線(xiàn)性區和完全導通區。其中,線(xiàn)性區也稱(chēng)恒流區、飽和區、放大區;完全導通區也稱(chēng)可變電阻區。
功率MOSFET在完全導通區和線(xiàn)性區工作時(shí)候,都可以流過(guò)大的電流。理論上,功率MOSFET是單極型器件,N溝道的功率MOSFET,只有電子電流,沒(méi)有空穴電流,但是,這只是針對完全導通的時(shí)候;在線(xiàn)性區,還是會(huì )同時(shí)存在電子和空穴二種電流,如圖4、圖5和圖6分別所示,完全導通區和線(xiàn)性區工作時(shí),電勢、空穴和電流線(xiàn)分布圖。
從電勢分布圖,功率MOSFET完全導通時(shí),VDS的壓降低,耗盡層完全消失;功率MOSFET在線(xiàn)性區工作時(shí),VDS的電壓比較高,耗盡層仍然存在,此時(shí)由于在EPI耗盡層產(chǎn)生電子-空穴對,空穴也會(huì )產(chǎn)生電流,參入電流的導通。
空穴電流產(chǎn)生后,就會(huì )通過(guò)MOSFET內部的BODY體區流向S極,這也導致有可能觸發(fā)寄生三極管,對功率MOSFET產(chǎn)生危害。由空、電流線(xiàn)穴分布圖可見(jiàn):線(xiàn)性區工作時(shí)產(chǎn)生明顯的空穴電流,電流線(xiàn)也擴散到P型BODY區。

圖4:完全導通(左)和線(xiàn)性區的電勢分布圖

圖5:完全導通(左)和線(xiàn)性區的空穴分布圖

圖6:完全導通(左)和線(xiàn)性區的電流線(xiàn)分布圖
功率MOSFET在線(xiàn)性區工作時(shí),器件同時(shí)承受高的電壓和高的電流時(shí),會(huì )產(chǎn)生下面的問(wèn)題:
1、內部的電場(chǎng)大,注入更多的空穴。
2、有效的溝道寬度比完全導通時(shí)小。
3、改變Vth和降低擊穿電壓。
4、Vth低,電流更容易傾向于局部的集中,形成熱點(diǎn);負溫度系數特性進(jìn)一步惡化局部熱點(diǎn)。
功率MOSFET工作在線(xiàn)性區時(shí),器件承受高的電壓,耗盡層高壓偏置導致有效的體電荷減??;工作電壓越高,內部的電場(chǎng)越高,電離加強產(chǎn)生更多電子-空穴對,形成較大的空穴電流。特別是如果工藝不一致,局部區域達到臨界電場(chǎng),會(huì )產(chǎn)生非常強的電離和更大的空穴電流,增加寄生三極管導通的風(fēng)險。
圖7為通用Trench和SGT屏蔽柵(分離柵)完全導通的電流線(xiàn),圖7來(lái)源于網(wǎng)絡(luò )。新一代SGT工藝的功率MOSFET局部區域電流線(xiàn)更密急,更容易產(chǎn)生局部的電場(chǎng)集中,因此,如果不采取特殊的方法進(jìn)行優(yōu)化,很難在線(xiàn)性區的工作狀態(tài)下使用。

圖7:Trench(左)和SGT屏蔽柵電流線(xiàn)分布圖
來(lái)源:松哥電源






