【導讀】TI正在設計基于GaN原理的綜合質(zhì)量保證計劃和相關(guān)的應用測試來(lái)提供可靠的GaN解決方案。氮化鎵(GaN)的材料屬性可使電源開(kāi)關(guān)具有令人興奮且具有突破性的全新特性—功率GaN。
高電子遷移晶體管(HEMT)。HEMT是一種場(chǎng)效應晶體管(FET),會(huì )使導通電阻會(huì )低很多。它的開(kāi)關(guān)頻率要比同等大小的硅功率晶體管要快。這些優(yōu)勢使得功率轉換的能效更高,并且能夠更加有效地使用空間。GaN可以安裝在硅基板上,這樣可充分利用硅制造能力,并實(shí)現更低的成本。然而,在使用新技術(shù)時(shí),需要驗證這項技術(shù)的可靠性。這份白皮書(shū)的主題恰恰是GaN器件質(zhì)量鑒定。
簡(jiǎn)介
由于有超過(guò)30年的經(jīng)驗,并且經(jīng)過(guò)不斷改進(jìn),這個(gè)行業(yè)理所當然地認為硅功率晶體管具有很高的穩定性。這種長(cháng)期的用戶(hù)體驗已經(jīng)形成了一整套成熟的質(zhì)量鑒定法方法體系;在這個(gè)方法體系中,可靠性和質(zhì)量由運行標準化測試進(jìn)行認證。這些測試來(lái)源于故障模式理解、激勵能量和加速因子方面的深入研究,以及推測使用壽命、故障率和缺陷率的統計與數學(xué)框架的開(kāi)發(fā)。由于數代硅產(chǎn)品可以在實(shí)際使用條件下,實(shí)現真正使用壽命內的正常運行,這個(gè)質(zhì)量鑒定方法體系現在已經(jīng)被證明是有效且實(shí)用的。
然而,GaN晶體管是近期才被開(kāi)發(fā)出來(lái)的器件。更加昂貴的碳化硅基板上的RF GaN HEMT已經(jīng)被廣泛應用于無(wú)線(xiàn)基站內,并且其可靠性已經(jīng)得到驗證。雖然基于相似的基本原理,功率GaN HEMT在實(shí)現更高電壓處理方面增加了更多的特性。它植根于硅基板上,并且使用與硅制造兼容的材料來(lái)降低成本。此外,出于故障安全的原因,它需要是一個(gè)增強模式 (e-mode),或者是常關(guān)器件。
主要有三種架構:
1. 與一個(gè)e-mode Si FET共源共柵的耗盡模式 (d-mode) 絕緣柵極GaN HEMT;2. e-mode絕緣柵極GaN HEMT;3. P型e-mode結柵極GaN HEMT。這三款器件會(huì )由于自身的原因,以及硅FET的影響而具有不同的故障模式,問(wèn)題是如何鑒定它們的質(zhì)量?;诠璧臉藴寿|(zhì)量鑒定方法是一個(gè)有價(jià)值且具有里程碑意義的質(zhì)量和可靠性鑒定方法,但不清楚的是,在器件使用壽命、故障率和應用相關(guān)性方面它對于GaN晶體管的效用如何。
德州儀器 (TI) 是半導體技術(shù)方面的行業(yè)領(lǐng)導者,在將可靠的半導體產(chǎn)品推向市場(chǎng)方面具有長(cháng)期的經(jīng)驗,其中包括鐵電隨機訪(fǎng)問(wèn)存儲器 (FRAM) 等非硅材料技術(shù)。在通過(guò)GaN相關(guān)質(zhì)量鑒定方法體系和應用相關(guān)測試,把可靠的GaN產(chǎn)品推向市場(chǎng)方面,我們具有很大的優(yōu)勢。
標準質(zhì)量鑒定方法體系
在鑒定硅功率器件質(zhì)量方面,有兩個(gè)標準化組織的質(zhì)量鑒定方法體系得到廣泛使用:聯(lián)合電子設備工程委員會(huì )(JEDEC);和汽車(chē)電子協(xié)會(huì )(AEC)[2, 3, 4, 5]。這些標準指定了很多測試,其中可以分為三類(lèi):靜電放電 (ESD)、封裝和器件。
靜電放電要求是一項強制的操作標準,所以ESD標準不太可能會(huì )發(fā)生變化。封裝測試與那些針對硅芯片、已經(jīng)完成的測試相類(lèi)似,需要找到導致故障的根本原因,以強調意外的故障機制。之前在硅芯片中使用的后端處理也同樣用于GaN,在這個(gè)背景下,由于封裝應力、結合表面相互作用等問(wèn)題比較常見(jiàn),所以這個(gè)相似性也就凸現出來(lái)。然而,這個(gè)器件類(lèi)別是全新的,并因此具有特別的重要性。后面的段落檢查了標準硅芯片質(zhì)量鑒定方法體系,并且描述了如何將這一方法體系應用于GaN。
對于硅芯片質(zhì)量鑒定來(lái)說(shuō),標準應力下的運行時(shí)間為1000h,結溫至少為125°C。假定激活能量為0.7eV,指定溫度加速因子為78.6 。這使得125°C結溫下的1000h運行時(shí)間所受應力等于Tj = 55°C情況下,9年運行時(shí)間內所受應力。器件在它們的最大運行電壓下進(jìn)行質(zhì)量鑒定。對于分立式功率FET,這通常選擇為最小擊穿電壓技術(shù)規格的80%。這意味著(zhù),在質(zhì)量鑒定測試條件下,沒(méi)有內置的電壓加速;電壓加速只由溫度實(shí)現。由于Tj在55°C以上,通常情況下高于75°C,這一點(diǎn)會(huì )對功率器件產(chǎn)生巨大影響。
這個(gè)標準還指定了3個(gè)批次的產(chǎn)品,每個(gè)批次有77個(gè)部件,不應在應力下出現故障。231個(gè)部件中的零故障標準意味著(zhù)批內缺陷允許百分比 (LTPD) 的值為1。這表示,你有9成的把握地宣稱(chēng),在推測的應力條件下,一個(gè)批次內有1%的部件是有缺陷的。換句話(huà)說(shuō),在Tj = 55°C的溫度條件下運行9年,在最大工作電壓上被偏置。最初地最大故障率 (FIT) 大約為50。Tj = 55°C下的FIT也是使用0.7eV的激活能量,從231個(gè)部件的零故障結果中得出。
然而,除了靜態(tài)測試,還有一個(gè)動(dòng)態(tài)測試。它被非常寬泛地定義為“有可能在一個(gè)動(dòng)態(tài)工作模式下運行的器件”。由廠(chǎng)商對測試進(jìn)行定義。由于很難指定一個(gè)與大范圍不斷發(fā)展的應用和技術(shù)相對應的測試,所以缺少指定測試。指定測試也許不能與實(shí)際使用環(huán)境適當關(guān)聯(lián),并且有可能產(chǎn)生錯誤故障,或者無(wú)法加快有效故障機制。
對于硅FET來(lái)說(shuō),已經(jīng)在很多年的實(shí)際使用過(guò)程中建立起來(lái)質(zhì)量鑒定方法體系的可信度。與GaN等全新技術(shù)不同的是,器件廠(chǎng)商負責確定它們的動(dòng)態(tài)測試可以預測實(shí)際使用的運行情況。因此,需要開(kāi)發(fā)出應用相關(guān)的應力測試,可以在實(shí)際使用條件下驗證可靠性。
最后,需要注意的一點(diǎn)是,GaN無(wú)法耐受雪崩能量。也就是說(shuō),器件將在被擊穿時(shí)損壞。這是一個(gè)需要解決的問(wèn)題,特別是對于功率因數校正 (PFC) 電路等高壓應用來(lái)說(shuō)更是如此;在這些應用中,器件會(huì )受到有可能出現的過(guò)壓事件的影響,比如說(shuō)電力線(xiàn)路上的閃電尖峰放電。
標準質(zhì)量鑒定方法體系的適用性
JEDEC和AEC標準均基于健全完善的基本原理,不過(guò)技術(shù)上比較落后。雖然通過(guò)硅產(chǎn)品質(zhì)量鑒定是一件有價(jià)值的、里程碑式的重大事件,但是用戶(hù)需要一個(gè)能夠在實(shí)際使用條件下,在所需的使用壽命內,比如說(shuō)10年,以低故障率持續運行的產(chǎn)品。因此,推出FRAM、成比例CMOS、GaN等新技術(shù)的公司需要了解這些標準的基本原理。在JEDEC質(zhì)量鑒定方法體系中,主要的促進(jìn)要素是溫度。根據方程式eq.(1)計算出加速因子 (AF),在這里EA是激活能量,而k是玻爾茲曼常數。

如果在應力溫度Tj = 125°C、使用溫度Tj = 55°C,并且激勵能量大約為0.7eV的情況下使用eq (1),得出的加速因子將為78.6。這也是Tj = 125°C情況下1000h應力大致相當于Tj = 55°C情況下使用10年的原因。在已經(jīng)發(fā)表的文獻中,GaN 的激勵能量在1.05到2.5eV之間變化。這些寬范圍的值表現出世界上不同實(shí)驗室和公司內器件、工藝和材料間的差異。這個(gè)范圍能夠提供大幅變化的加速因子,比如EA = 1.05eV下的687到EA = 2.5eV下5百萬(wàn)以上的值。因此,有必要確定與工藝和最終產(chǎn)品的器件架構有關(guān)的激勵能量。
將實(shí)際運行中的結溫考慮在內也很重要。由于其所具有的寬帶隙,相對于硅材料,GaN能夠在更高的溫度環(huán)境中運行。這一點(diǎn)對于電力電子產(chǎn)品很重要。表1是125°C應力溫度下的1000h硅技術(shù)規格與其它幾種情況下的比較。從表1中可以看出,如果需要105°C的結工作溫度,假定激活能量為0.7eV,非加速時(shí)間從9年減少為0.3年。通過(guò)將應力溫度增加到150°C(這是一個(gè)針對標準封裝的實(shí)際限值),有可能將這個(gè)時(shí)間增加到1.1年。在這個(gè)情況下,應力測試并不符合現場(chǎng)等效使用壽命,或者解算出大約50 FIT的最大FIT率條件。然而,它的確是一項可靠且高質(zhì)量的里程碑式的測試方法。
代表10年使用時(shí)間的1000h應力測試需要一個(gè)值為87.6的加速因子,并且在1.37的激勵能量下實(shí)現。諸如參考文獻中1.05eV的更低激勵能量將需要2.84倍的電壓加速,或者大約延長(cháng)6到17周的持續時(shí)間。過(guò)多的電壓加速會(huì )導致不具代表性的故障模式,而持續時(shí)間擴展延長(cháng)了新產(chǎn)品的開(kāi)發(fā)時(shí)間。根據故障模式和封裝內可提供的加速的不同,也許無(wú)法實(shí)現能夠表示所需現場(chǎng)等效使用壽命的質(zhì)量鑒定測試。使用壽命要求由晶圓級可靠性測試提供保證,并且由已封裝部件的擴展持續時(shí)間應力測試進(jìn)行驗證。

表1:不同應力參數對可靠性和質(zhì)量推測數據的影響
根據GaN的特定故障模式來(lái)設定故障標準很重要。一個(gè)特別的故障就是動(dòng)態(tài)Rds導通電阻增加,也被稱(chēng)為電流崩塌。這一故障由緩沖和頂層的負電荷陷獲所導致 [9, 10]。電荷會(huì )在施加高壓時(shí)被誘陷,并且不會(huì )在器件接通時(shí)立即耗散。
被陷獲的負電荷排斥來(lái)自通道層的電子,而Rds導通電阻會(huì )由于通道層內的電子數量的減少而增加(圖1)。隨后,Rds導通電阻隨著(zhù)被陷獲電荷的耗散而恢復。這一影響降低了效率,并且會(huì )使得器件自發(fā)熱量過(guò)多,并且會(huì )過(guò)早地出現故障。
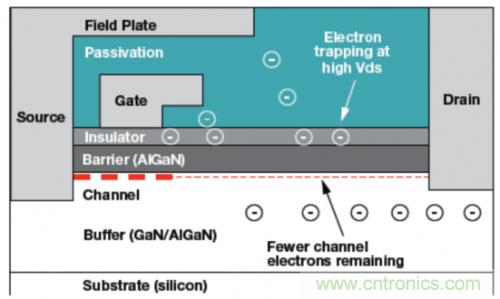
圖1:一個(gè)GaN器件的電路橫截面顯示被陷獲的電子如何通過(guò)減少通道層中的電子數量來(lái)增加Rds導通電阻。
此外,陷獲密度會(huì )隨著(zhù)器件老化而增加,從而使得動(dòng)態(tài)Rds導通電阻的影響更加嚴重。我們有專(zhuān)門(mén)的硬件來(lái)監視應力測試過(guò)程中的動(dòng)態(tài)Rds導通電阻,這使得我們能夠確保發(fā)布的產(chǎn)品沒(méi)有這方面的問(wèn)題。
應用相關(guān)測試
雖然DC測試方法在對大量部件進(jìn)行測試時(shí)相對簡(jiǎn)單,它們也許不能預測GaN是否在實(shí)際應用中具有10年的使用壽命。硬開(kāi)關(guān)應力不同于DC應力。硬開(kāi)關(guān)功率轉換器具有電感開(kāi)關(guān)變換,在這個(gè)期間,器件同時(shí)受到高電流和高壓的影響。由于FET通道需要漏電壓,Vds,下降前灌入整個(gè)電感器電流,并且對那個(gè)節點(diǎn)上的其它器件進(jìn)行反向恢復放電,接通變換是一個(gè)應力最高的過(guò)程。它還需要在Vds下降時(shí)承載器件放電輸出和開(kāi)關(guān)節點(diǎn)電容內的額外電流。由于FET通道在Vds較低,并且電感器電流為各自的電容器充電時(shí)關(guān)閉,所以關(guān)閉的應力相對較低。
器件應力由使用圖2中所示拓撲的升壓轉換器顯示。圖3中顯示的是初級側開(kāi)關(guān) (FET1) 上硬開(kāi)關(guān)接通變換的仿真結果。輸入電壓為200V,而電感器電流為5A(負載電流大約為2.5A)。在這個(gè)情況下,當FET1關(guān)閉時(shí),由于鉗制FET (FET2) 導電,它的漏電壓大約鉗制在400V。因此,當FET1接通時(shí),它需要在Vds開(kāi)始下降之前灌入整個(gè)電感器電流(區域A)。
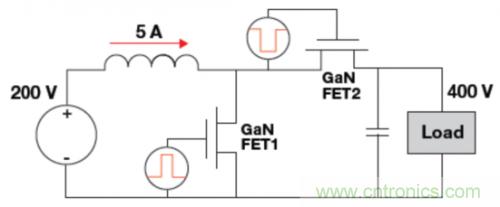
圖2:一個(gè)簡(jiǎn)單的升壓轉換器拓撲。
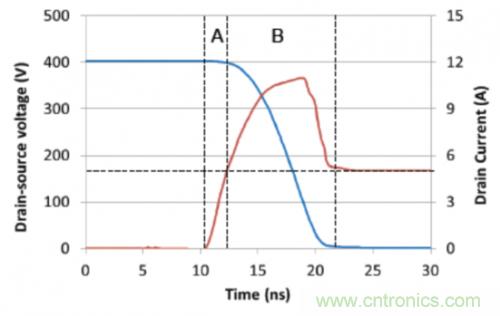
圖3:針對一個(gè)硬開(kāi)關(guān)變換的接通轉換。
隨著(zhù)漏電壓下降(區域B),FET需要將開(kāi)關(guān)節點(diǎn)上的電容器放電。這些電容器中的電荷來(lái)自鉗制FET、電路板引線(xiàn)和其它連接的組件。由于使用了GaN FET,沒(méi)有來(lái)自這個(gè)鉗位的反向恢復電流。V-I關(guān)系曲線(xiàn)(圖4)顯示出,在高Vds時(shí),會(huì )汲取大量電流。在這個(gè)情況下,大約比電感器電流高6A。由于FET的漏電容通過(guò)通道放電,實(shí)際的FET通道電流更高。例如,值為50pF,轉換率為60V/ns的漏電容會(huì )增加額外的3A電流。

圖4:一個(gè)電感開(kāi)關(guān)變換的V-I關(guān)系曲線(xiàn)顯示出漏極偏置電壓較高時(shí)會(huì )出現數量可觀(guān)的電流。FET漏電容的放電增加了額外的通道電流,例如,60V/ns的50pF電容值會(huì )增加3A電流。
硬開(kāi)關(guān)期間,高Vds時(shí)充足的FET通道電流會(huì )導致熱載流子生成,正因如此,器件需要穩健耐用。此外,大器件陣列會(huì )遇到不一致的開(kāi)關(guān),這有可能會(huì )使器件電流涌入最先接通的那一部分器件陣列,并且超過(guò)本地額定值。高dv/dt開(kāi)關(guān)還會(huì )錯誤地將電容電流引入器件的某一區域,比如說(shuō)端子。需要完成可靠性測試,特別是在需要確保器件在硬開(kāi)關(guān)應用中的穩健耐用性時(shí)更是如此,并且可靠開(kāi)關(guān)安全工作區 (SOA) 限定了器件的用戶(hù)使用條件。
為了驗證硬開(kāi)關(guān)穩健耐用性,TI已經(jīng)開(kāi)發(fā)出一個(gè)基于簡(jiǎn)單升壓轉換器的電感開(kāi)關(guān)單元(圖5)。根據JEDEC建議進(jìn)行選型,即“取決于故障模式和所關(guān)心的機制,由于實(shí)際產(chǎn)品復雜度有可能會(huì )掩蓋固有的故障機制,所以試驗模型也許更受歡迎。”
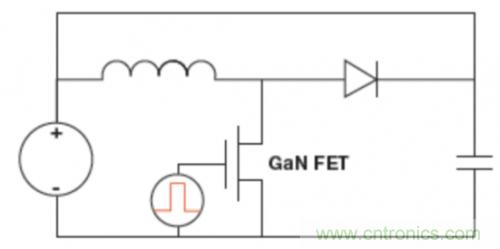
圖5:針對電感開(kāi)關(guān)應用測試的試驗模型。
當GaN FET關(guān)閉時(shí),電感器電流通過(guò)一個(gè)二極管再次流至輸入端,這就免除了對負載電阻器的需要,并且能夠達到節能的目的。這個(gè)單元與處于連續電流模式下的電感器一同運行。由于目標是開(kāi)關(guān)變換,通過(guò)使用短占空比,可以達到節能的目的。這個(gè)元件能夠改變施加的電壓、電流、頻率,以及器件所處環(huán)境的溫度。額外的漏電流(圖4)由二極管電容提供。
可以按照需要增加額外電容。這個(gè)元件還具有一個(gè)硬件,可以在開(kāi)關(guān)變換的1微秒后測量器件的動(dòng)態(tài)導通電阻 (dRds-on)。由于dRds-on會(huì )隨著(zhù)應力而增加,從而導致導電損耗增加、效率降低,因此這個(gè)實(shí)時(shí)監視功能是很有必要的。在一個(gè)產(chǎn)品中,不斷增加dRds-on將導致過(guò)多的器件自發(fā)熱和過(guò)熱故障。由于Rds-on性能下降會(huì )恢復,不太可能通過(guò)將應力停止,在“上拉或下拉點(diǎn)”上獲得這些數據。監視這個(gè)關(guān)鍵GaN故障參數使我們能夠避免發(fā)布的產(chǎn)品出現這個(gè)問(wèn)題。
除了電感開(kāi)關(guān)測試,GaN多芯片模塊需要在系統中進(jìn)行評估,并且在實(shí)際的產(chǎn)品使用條件下運行。這樣可以驗證與其它系統組件的交互作用,并且暴露出未知的故障機制。即使單個(gè)組件是可靠的,它們之間的交互作用也可能會(huì )在意料之外。例如,在一個(gè)共源共柵GaN器件中,通過(guò)GaN器件漏源電容的電荷耦合會(huì )使得硅共源共柵器件在關(guān)閉變換期間出現雪崩擊穿。
有必要專(zhuān)門(mén)來(lái)說(shuō)一說(shuō)雪崩擊穿的耐受性。目前,GaN HEMT并未顯現出雪崩能力。由于GaN本身是支持雪崩的,所以這也許會(huì )隨著(zhù)技術(shù)成熟而得以改進(jìn)。與此同時(shí),我們正在設計具有足夠裕量的TI產(chǎn)品,來(lái)解決遇到的過(guò)壓情況。例如,在PFC應用的情況下,如果電力線(xiàn)被閃電擊中時(shí), FET上的電壓有可能瞬時(shí)上升到高達700V。對于這個(gè)應用,將制造能夠至少耐受750V尖峰電壓的GaN器件。
結論
德州儀器 (TI)在硅產(chǎn)品質(zhì)量鑒定方面擁有長(cháng)期的專(zhuān)業(yè)知識積累,我們將這些專(zhuān)業(yè)知識應用于GaN的質(zhì)量鑒定方面。這就需要重新學(xué)習基本原理,以理解硅質(zhì)量鑒定過(guò)程的起源,以及根據GaN特定故障、激勵能量和加速因子來(lái)創(chuàng )建測試。它還涉及針對相關(guān)應用中GaN的質(zhì)量鑒定,其方法是在一個(gè)特殊電感開(kāi)關(guān)試驗模型中進(jìn)行應力測試,并且在實(shí)際產(chǎn)品配置中運行部件。







